Политика использования файлов «cookie»
Файлы «cookie» помогают нам адаптировать сайт в соответствии с вашими потребностями, такими как язык или сфера интересов. Пожалуйста, подтвердите, что вы согласны на использование нами файлов «cookie».
Пресс-релизы
Mitsubishi Electric разработала первый в мире многоячеистый транзистор GaN-HEMT с непосредованным соединением с алмазной подложкойПовышение энергоэффективности и надежности СВЧ-электроники
Этот текст является переводом официальной версии пресс-релиза с английского языка и приведен исключительно для вашего удобства. В случае каких-либо несоответствий оригинальная версия на английском языке имеет приоритетное значение.
ПРЕСС-РЕЛИЗ № 3298 ДЛЯ НЕМЕДЛЕННОГО РАСПРОСТРАНЕНИЯ
Токио, 2 сентября 2019 г. - Корпорация Mitsubishi Electric (TOKYO: 6503) совместно с Исследовательским центром глобальных микроэлектромеханических систем (МЭМС) и микротехники Национального Института Прогрессивной Промышленной Науки и Технологии (AIST) объявила о разработке нового транзистора с высокой подвижностью электронов на базе нитрида галлия (GaN-HEMT).
Прибор имеет многоячеистую структуру (т. е. состоит из множества параллельно расположенных транзисторных ячеек) и соединяется напрямую с обладающей высокой теплопроводностью монокристаллической теплоотводящей алмазной подложкой. Это первый в мире многоячеистый GaN-HEMT, изготовленный с помощью прямого соединения транзистора с монокристаллической алмазной подложкой.* Инновационное устройство с высокой подвижностью электронов на основе нитрида галлия с алмазной подложкой (GaN-on-Diamond HEMT) повысит КПД суммирования мощности усилителей в базовых станциях мобильной связи и системах спутниковой связи, тем самым способствуя сокращению потребления энергии. Mitsubishi Electric сейчас проводит оптимизацию конструкции транзистора GaN-on-Diamond HEMT до его выхода на рынок, намеченного на 2025 год.
- * По данным исследований Mitsubishi Electric на 2 сентября 2019 г.
Впервые об этом научном достижении было объявлено на Международной конференции по твердотельным приборам и материалам (SSDM), которая проходит в Университете Нагоя (Япония) со 2 по 5 сентября текущего года.
-
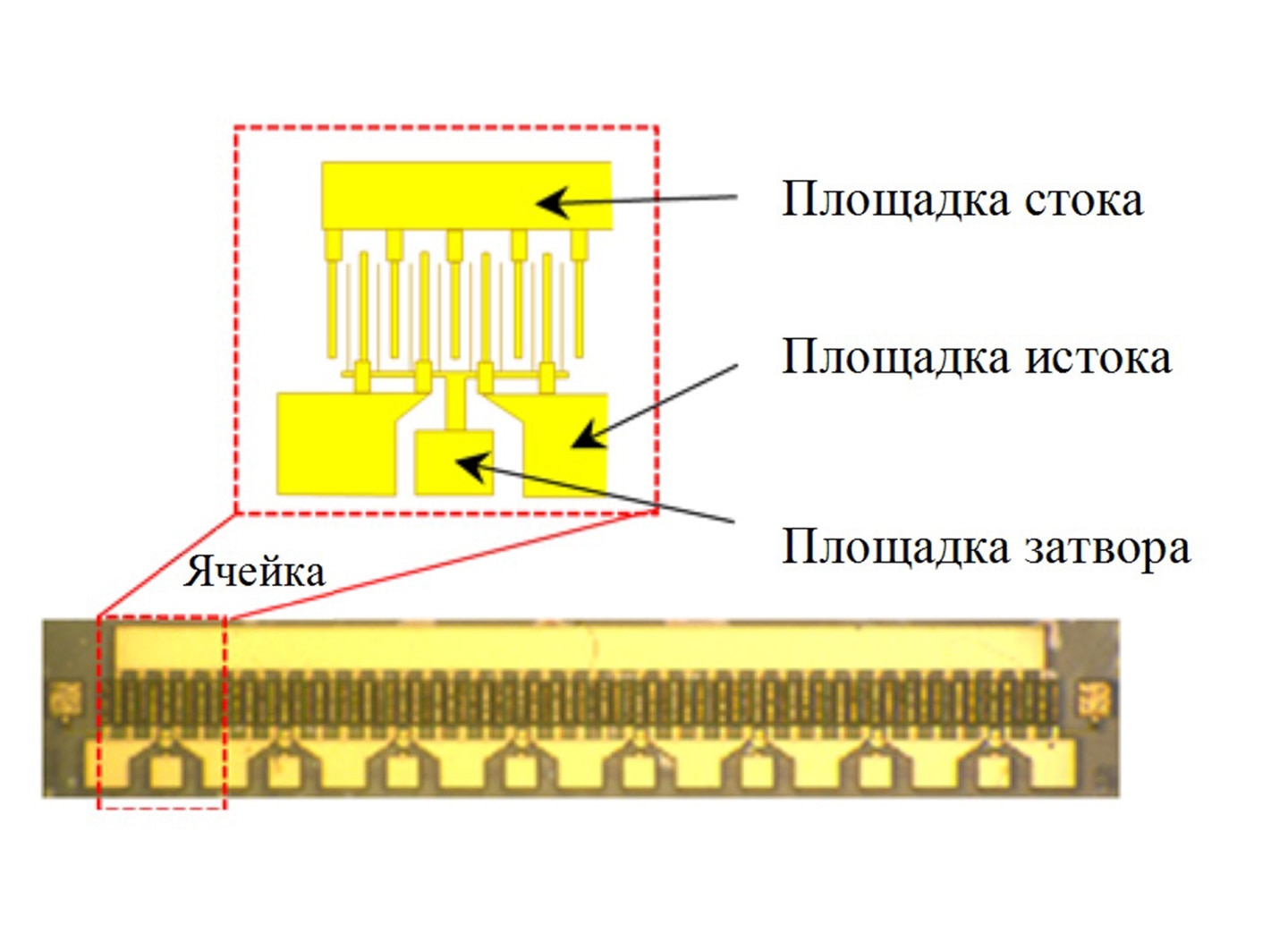
Новый GaN-on-Diamond HEMT Ячеистая структура, вид сверху
-
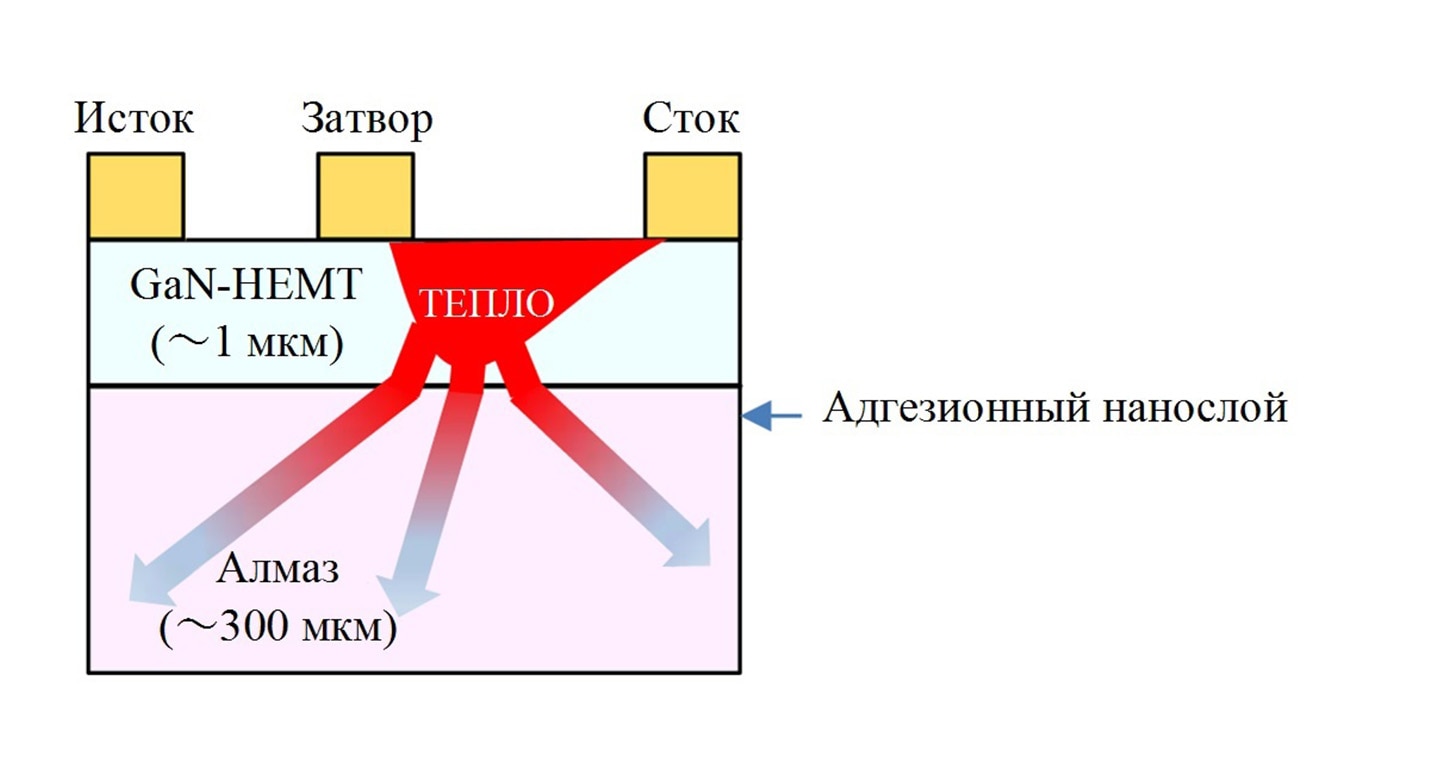
Вид нового GaN-on-Diamond HEMT в поперечном разрезе
Корпорация Mitsubishi Electric занималась проектированием, изготовлением, оценкой и анализом GaN-on-Diamond HEMT, а уже в Национальном Институте Прогрессивной Промышленной Науки и Технологии (AIST) разработали технологию прямого соединения.
Частично это достижение основано на результатах, полученных в рамках проекта, заказанного Организацией по развитию новых энергетических и промышленных технологий (NEDO).
Ключевые характеристики
- 1)Первый в мире многоячеистый GaN-HEMT на алмазной подложке
Большинство существующих транзисторов GaN-HEMT с теплоотводной алмазной подложкой изготавливаются с использованием пленки с эпитаксиальным слоем GaN, из которой удалена кремниевая подложка и на которую алмаз осаждается в условиях повышенной температуры. Затем осуществляется сборка транзисторов HEMT на алмазной подложке пластины GaN. Однако, поскольку коэффициенты теплового расширения GaN и алмаза различны, пластина может сильно деформироваться в процессе производства, а это затрудняет сборку больших многоячеистых транзисторов GaN-HEMT.
В ходе упомянутого выше исследования, из оригинального многоячеистого транзистора GaN-HEMT удалили кремниевую подложку, его тыльную поверхность подвергли шлифовке для утончения и уплощения, после чего соединили непосредственно с алмазной подложкой при помощи адгезионного нанослоя. Многоячеистая структура использовалась для параллельного расположения восьми транзисторных ячеек, относящихся к типу, который используется в современных изделиях. Таким образом, была выполнена сборка первого в мире многоячеистого транзистора GaN-on-Diamond HEMT на основе монокристаллического алмаза с высокой степенью теплоотдачи. - 2)Улучшенная выходная мощность и энергоэффективность для расширенного диапазона радиоволн и энергосбережения по сравнению с оригинальным GaN-HEMT с такой же структурой, но на кремниевой подложке
Благодаря использованию монокристаллического алмаза (теплопроводностью 1900 Вт/мК), обладающего превосходными теплоотводящими свойствами, рост температуры GaN-HEMT уменьшается с 211,1 до 35,7 °С, что блокирует процесс термической деструкции. Это повышает отдаваемую мощность с 2,8 до 3,1 Вт на 1 мм ширины затвора и увеличивает КПД по добавленной мощности с 55,6 до 65,2%, тем самым обеспечивая значительную экономию энергии.
Обратите внимание, что пресс-релизы являются актуальными на момент публикации и могут быть изменены без уведомления.



